2024年3月20日-22日,半导体行业盛会SEMICON CHINA 2024在上海新国际博览中心盛大举行。帝科湃泰PacTite精彩亮相并展示其创新的半导体封装浆料解决方案:LED封装、IC封装、功率半导体封装,以及电子元器件、印刷电子等领域的明星产品,与行业同仁共襄盛会。

多维产品组合,赋能澎湃中国“芯”
作为全球领先的电子材料公司,帝科DKEM以先进配方化材料技术平台为依托,聚焦金属化与互联技术专长,在深耕太阳能光伏领域的同时,积极拓展湃泰PacTite品牌的多维半导体电子材料产品组合。
湃泰PacTite以LED与IC封装银浆为技术及市场突破口,以功率半导体系列封装浆料为未来发展方向,积极布局电子元器件与印刷电子应用,推出了DECA200/DECA400系列LED芯片封装银胶与IC芯片封装银胶、DECA600/DECA610系列功率半导体封装烧结银以及DK1200系列AMB陶瓷覆铜板钎焊浆料等半导体封装用系列产品组合。

创新材料,点亮LED多彩未来
作为本次展会的明星产品之一,帝科湃泰PacTite DECA200/400系列LED芯片封装银胶,凭借前沿的创新能力,提高了LED导电胶产品的操作性能和可靠性,获得广大行业客户的高度认可,整体性能已达到主流国际品牌水平。目前已实现:
· 满足LED封装对高散热性、高粘接性和高可靠性的要求
· 广泛应用于LED显示和照明行业,行业头部客户稳定量产
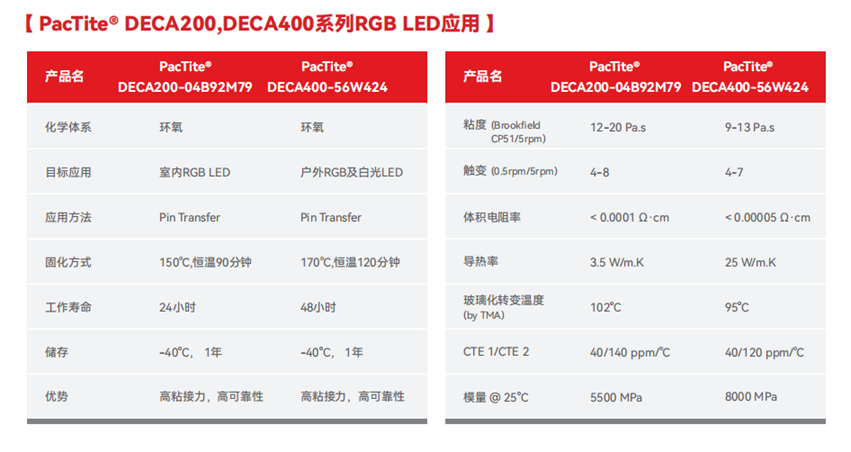
压力烧结银,助力车载功率半导体发展
随着全球新能源市场的火热发展,大功率IGBT器件广泛应用于电机驱动、车载充电模块;以及新能源功率模块对工作温度和可靠性的要求越来越高,催生SiC和GaN等宽禁带半导体芯片的普及应用,烧结银工艺成为提升其封装可靠性和性能的关键技术。
展会期间,帝科湃泰PacTite展示了可实现低电阻、高散热、高密度封装的DECA610系列压力烧结银产品。作为解决行业瓶颈的关键性技术,DECA610系列以实现:
· 200 W/m·K超高导热率,为器件提供更高寿命
· ≤ 0.00001 ·cm超低电阻率, 提升器件性能
· 优秀的粘接力为器件提供更好的可靠性
· 优秀的钢网印刷性能
· 无铅无卤的环保材料

前沿突破,引领半导体封装材料国产化
AMB陶瓷覆铜板作为SiC/GaN等第三代半导体和新型大功率电力电子器件的首选封装材料。帝科湃泰PacTite针对性开发的适用于Al2O3、AlN、Si3N4、SiC等陶瓷基材的DK1200系列专用钎焊浆料,成功实现了对进口浆料的国产替代,受到了业界的持续关注:· 稳定高效的印刷性、极低的空洞率· 优异的铜层结合力· 蚀刻快速且无残留· 有效满足各类高可靠性应用场景的严苛需求。
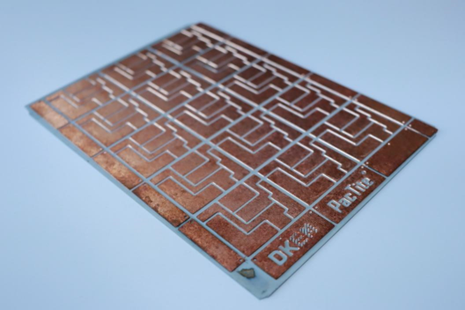
同时,帝科湃泰PacTite推出DECA650系列金属熔融型瞬态液相烧结(TLPS) 导电浆料,适用于HDI、MPI、 LCP等电子电路填充微通孔结构或相关半导体测试基板用,可以实现电路叠层间高质量的金属间化合物 (IMC) 的互连导通,具有低温互联、高温服役的卓越可靠性。
本次展会中,帝科湃泰PacTite不仅全面展示了半导体封装解决方案,更与各位客户同仁就产品需求、挑战和行业趋势进行了积极的沟通,协同创新,助力行业突破边界,赋能中国“芯”。
激发无限可能 Inspire the Possibilities
本文作者可以追加内容哦 !

