
·聚焦:人工智能、芯片等行业
欢迎各位客官关注、转发
前言: 在半导体市场中,台积电和三星是唯二实现市场份额季度增长的公司。
其中,台积电的市场占有率上升了2%;而三星的晶圆代工业务以14%的市场份额稳固了其第二大参与者的地位,较第三季度的13%有所增长。
在当前半导体产业中,先进封装技术已成为推动创新、增强功能、性能和成本效益的关键因素。
由于先进封装工艺更偏向于前道工艺,因此晶圆代工厂与IDM厂商在该领域具备天然的先发竞争优势。
作者 | 方文三 图片来源 | 网 络

代工巨头联盟的形成与影响
在半导体技术发展的当前阶段,代工巨头通过组建联盟,共同推动先进封装技术的研发和应用,旨在把握行业发展的海量需求,进一步巩固和扩大其在半导体产业中的领导地位。
代工巨头联盟主要由行业内领先的半导体公司组成,它们共同面对着先进封装技术的快速发展和市场需求的激增。
目前,三星电子发起的MDI联盟成员已增至30家,包括存储、封装基板和测试厂商等,这一数字在一年内增长了10家。
台积电也成立了3DFabric联盟,成员能够及早获取台积电的3DFabric技术,实现与台积电同步开发及优化解决方案。
联盟的主要目标是推动先进封装技术的发展,通过整合各方资源,加速产品研发和市场推广,以应对AI芯片市场对高效封装的需求。
联盟成员致力于实现2.5D及3D异构集成封装技术,将CPU、GPU、HBM等多裸晶片整合到一个封装中,满足高性能计算(HPC)领域的需求。
联盟的形成对整个半导体产业产生了深远的影响。
首先,联盟成员之间的紧密合作有助于共享技术资源、降低研发成本、加速产品上市时间。
例如,台积电的3DFabric技术能够实现更佳的效能、功耗、尺寸外观及功能,达成系统级整合,这直接推动了封装技术的进步。
其次,联盟的扩员反映了市场对先进封装技术的高度认可和迫切需求。
随着AI技术的快速发展,算力需求与电路可容纳晶体管数量接近极限,堆叠和组合不同的芯片成为更有效的解决方案。
联盟成员通过共同研发,能够更快地响应市场需求,提供更高效的产品和服务。

USMAG联盟
在2022年2月,IFS正式启动了其加速器设计生态系统计划,旨在协助代工厂客户将其硅产品从概念阶段顺利过渡到实施阶段。
作为该计划的核心,IFS加速器向客户提供了一整套综合性工具,包括经过严格验证的EDA解决方案、硅验证IP以及专业的设计服务,从而确保客户能够集中精力创造独特且富有价值的产品创意。
英特尔代工服务(IFS)进一步推出了对其设计生态系统加速器计划的战略性补充——新的USMAG联盟。
该联盟旨在将值得信赖的设计生态系统与美国本土制造紧密结合,确保在先进工艺技术的支持下进行芯片设计与生产,以满足国家安全应用中严格的设计和生产标准。
该计划的初始成员涵盖了多家领先企业,包括Cadence、Synopsys、Siemens Digital Industries Software、Intrinsix以及Trusted Semiconductor Solutions。
为确保MAG应用所需的功能和操作安全性,先进制造商与其电子设计自动化(EDA)、IP以及设计服务联盟成员之间的紧密协作至关重要。
通过USMAG联盟,IFS将与联盟成员携手合作,确保他们具备在前沿技术节点上支持MAG设计的能力。
此外,该联盟还将确保EDA成员的工具得到优化,以提供安全的设计方法和流程,并能在安全的设计环境中运行,同时满足IFS工艺设计套件(PDK)的严格要求。
IFS还将与IP供应商成员紧密合作,提供符合MAG规范的高质量、高可靠性设计IP块。
最后,IFS将促使提供设计服务的成员运用IFS的参考流程和方法,以高效实施USMAG设计项目。
MDI联盟
台积电凭借CoWoS封装技术,在先进封装产业中占据主导地位,而三星则意图通过i-Cube等封装技术来挑战台积电的领先地位。
CPU与GPU因采用迥异的设计理念进行制造,导致整合过程极具挑战性。
尽管三星凭借其涵盖晶圆代工、HBM产品生产和封装技术等一站式解决方案而受益,但仍需应对芯片整合带来的各类软件问题。
为了更有效地解决此类问题,三星与芯片设计公司、测试与封装公司及电子设计自动化(EDA)供货商结成联盟。
三星于2023年6月启动了针对2.5D和3D封装技术的MDI联盟,旨在应对行动和高性能计算(HPC)应用中小芯片市场的迅速增长。
通过与合作伙伴及内存、封装基板和测试领域的主要厂商合作,构建2.5D和3D异质整合的封装技术生态系统,提供一站式服务,以支持客户的技术创新。
三星持续加强其在半导体封装技术领域的实力,努力缩小与台积电之间的技术差距。
计划于2024年扩大MDI联盟,合作伙伴数量由20家增至30家,即在一年内新增10家合作伙伴。
三星提供包括2.5D和3D在内的多种先进封装交钥匙解决方案,涵盖I-CubeS、I-CubeE、X-Cube (TCB) 和X-Cube (HCB)四种不同的封装类型。
据韩媒报道,三星电子在半导体封装领域取得了显著进展,将领先台积电涉足面板级封装(PLP)领域。
鉴于AI半导体芯片(带有电路的矩形部件)的尺寸通常为600mm x 600mm或800mm x 800mm,因此,三星正积极开发并加强与客户的合作,以利用PLP等技术。
三星计划于2024年推出先进的3D芯片封装技术SAINT,该技术能以更小的封装尺寸,将AI芯片等高性能芯片的内存和处理器集成。
三星SAINT将用于制定多样化的解决方案,并提供三种类型的封装技术,目前正处于概念验证阶段,即将以芯片形式推出,实现HBM内存的垂直集成。

3DFabric联盟
台积电于2022年正式成立了3DFabric联盟,旨在为半导体设计、内存模块、基板技术、测试、制造及封装等领域提供全面且综合的解决方案与服务。
此联盟在半导体行业内尚属首例,旨在通过台积电OIP生态系统合作伙伴的协同努力,推动3DFabric生态系统的创新与准备;
加速3DFabric技术的客户采纳与生产过程,进而将先进的逻辑技术与3DFabric技术相结合;
为半导体设计、内存模块、基板技术、测试、制造及封装等领域提供全方位且卓越的一流解决方案与服务,以此引领系统设计行业的发展。
目前,该联盟已与七个领域的领军企业展开合作,提供一系列高质量、即插即用的解决方案与服务。
据悉,台积电正在研发一种新型的先进芯片封装技术,该技术采用矩形基板而非传统的圆形晶圆,以在单个晶圆上容纳更多的芯片。
目前,这种矩形基板正处于试验阶段,其尺寸为510 mm x 515 mm,其可用面积超过传统圆形晶圆的三倍。采用矩形基板的设计将显著减少边缘未使用的面积。
台积电的3DFabric技术涵盖了前端3D芯片堆叠或TSMC-SoIC(系统整合芯片)技术,以及后端技术,包括CoWoS及InFO系列封装技术。
这些技术能够显著提升产品的效能、功耗、尺寸外观及功能,从而实现系统级的全面整合。
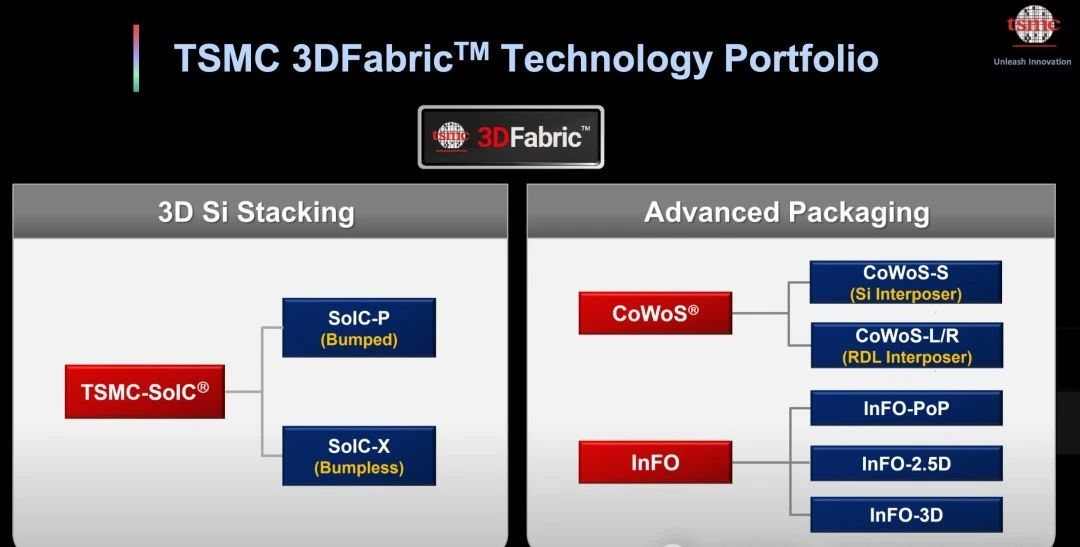
AI半导体联盟关系确定
今年4月,SK集团会长崔泰源抵达美国硅谷,并与英伟达的首席执行官黄仁勋进行了会面。
此次会晤的核心议题是围绕AI半导体关键零部件HBM的合作展开。
SK海力士,作为全球领先的高带宽内存(HBM)制造商,其生产的HBM产品具备世界顶尖的性能,且是AI GPU硬件不可或缺的关键组件。
目前,SK海力士为英伟达提供了超快的HBM3以及新型的HBM3E,以满足其对高性能AI GPU的硬件需求。
英伟达在其备受瞩目的Hopper H100 AI GPU中采用了HBM3技术,并在最新推出的Blackwell B200 AI GPU上配备了更为先进的超快HBM3E。
这一举措充分展示了英伟达对SK海力士HBM技术的认可与信赖。
为满足市场对HBM产品日益增长的需求,SK海力士近日宣布将投资146亿美元用于建设新的芯片工厂。
此外,该公司还计划与台积电携手,共同开发下一代HBM4内存技术,预计该产品将成为英伟达未来AI GPU的重要组成部分。
SK海力士还计划投资高达900亿美元,建设全球最大的超级晶圆厂,预计该工程将于2046年全面竣工。
这一举措将进一步提升SK海力士在全球半导体产业中的领先地位。
根据SK海力士发布的声明,该公司将充分利用台积电的先进工艺技术,以提升其产品的竞争力。
鉴于英伟达与台积电之间紧密的合作关系,此次SK海力士与英伟达加强合作,标志着AI半导体领域内的联盟关系正式确立,共同构建了一个强大的生态系统。
英伟达的成功离不开台积电和SK海力士的鼎力支持,三者之间的紧密合作形成了一个高效的战斗团队。
SK海力士负责生产高性能的HBM,而台积电则负责将GPU与HBM进行封装,共同打造出如H100、H200、B200等领先的AI芯片产品。

结尾:
随着算力时代的来临,堆叠封装技术的需求显著上升。
为顺应AI加速器和其他HPC芯片等高端市场迅速增长的趋势,台积电、英特尔、三星、SK海力士等海外大型企业以及中国大陆的三大封测厂商均已积极布局2.5D/3D先进封装平台。
此举预计将极大地推动先进封装设备、封装基板以及封装材料等相关领域的需求增长。
部分资料参考:闪德资讯:《全球垄断!三大芯片巨头成立联盟》,半导体行业观察:《台积电的先进封装:如何用3DFabric战略引领未来?》,湘论科技:《先进封装专题三:代工、IDM厂商先进封装布局各显神通》,半导体产业纵横:《联盟扩员,代工巨头“血拼”先进封装》
本公众号所刊发稿件及图片来源于网络,仅用于交流使用,如有侵权请联系回复,我们收到信息后会在24小时内处理。
END
本文作者可以追加内容哦 !

