AI应用浪潮之下,高性能存储器需求持续攀升,以HBM为代表的DRAM风生水起。同时,为进一步满足市场需求,存储厂商也在酝酿新一轮DRAM技术“革命”。
4F Square DRAM顺利开发
韩媒消息,近期三星电子副总裁柳昌植对外表示,三星下一代DRAM技术进展良好,除了1b DRAM正在顺利量产之外,4F Square DRAM技术也在顺利开发,计划在2025年开发出4F Square DRAM的初始样品。
资料显示,4F Square是三星开发的下一代DRAM技术,其中“F”是特征尺寸(Feature Size),用以衡量DRAM单元中晶体管等组件尺寸;“Square”则用于衡量向单元中的晶体管施加电压的组件面积大小。
业界表示,早期DRAM单元结构是8F Square,目前商业化的DRAM主要采用6F Square,与上述两项技术相比,4F Square采用垂直信道晶体管 ( VCT:vertical channel transistor ) 结构,可将芯片表面积减少30%。DRAM密度与性能随着单元面积的减小而提升,因此AI等应用推动之下,4F Square这项技术也逐渐受到存储大厂的青睐。
此前三星表示,许多公司正努力将技术过渡到4F Square VCT DRAM,不过需要克服一些困难,包括开发氧化物沟道材料和铁电体等新材料等。业界认为,2025年三星4F Square DRAM的初始样品或为对内发布,另一家半导体厂商东京电子预估,采用VCT和4F Square技术的DRAM将在2027年至2028年出现。
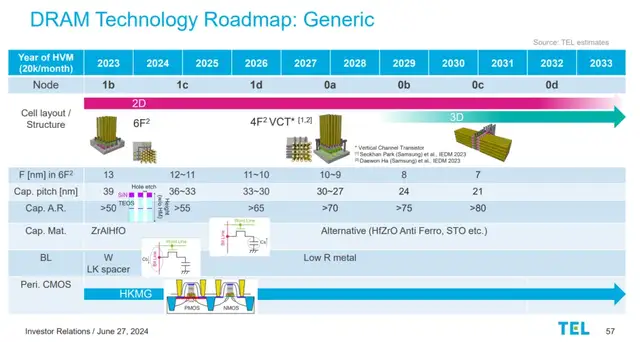
除此之外,早前媒体还报道,三星计划应用混合键合(Hybrid Bonding)技术支持4F Square DRAM的生产,混合键合是下一代封装技术,指的是芯片垂直堆叠,能提高单元密度,进而提高性能,该技术也将对HBM4以及3D DRAM带来影响。
HBM4呼之欲出
AI时代下,HBM尤其是HBM3E在存储器市场发展如鱼得水,引发三大DRAM原厂争相布局。同时,新的较量也开始打响,主要围绕下一代HBM4技术展开。

今年4月SK海力士已经宣布将携手台积电共同开发HBM4。据悉,两家公司将首先致力于针对搭载于HBM封装内最底层的基础裸片(Base Die)进行性能改善。HBM是将多个DRAM裸片(Core Die)堆叠在基础裸片上,并通过TSV技术进行垂直连接而成;为专注下一代HBM4技术的开发,三星已经成立了新的“HBM开发团队”。7月,三星电子存储部门新事业企划组组长Choi Jang-seok透露,公司正在开发单堆栈达48GB的大容量HBM4内存,预计明年投产。近期,媒体报道,三星计划使用4nm先进制程工艺生产HBM4 逻辑裸晶(Logic Die);美光则规划2025年—2027年推出HBM4 ,而到2028年则正式步入HBM4E。
除了生产工艺之外,DRAM原厂针对未来HBM,还在积极布局混合键合技术。相较现有键合工艺,混合键合无需在DRAM内存层间添加凸块,而是将上下两层直接铜对铜连接,可显著提高信号传输速率,更适应AI计算对高带宽的需求。
今年4月,媒体报道三星成功制造了基于混合键合技术的16层堆叠HBM3内存,该内存样品工作正常,未来16层堆叠混合键合技术将用于HBM4量产;SK海力士计划于2026年在其HBM生产中采用混合键合;此外,美光也正着手开发HBM4,会考虑采用包括混合键合在内等相关技术,目前一切都在研究中。
3D DRAM进程加速
3D DRAM(三维动态随机存取内存)是一种具有全新存储单元结构的DRAM技术,不同于传统DRAM水平放置存储单元,3D DRAM通过垂直堆叠存储单元的方式,可显著提高单位面积内的存储容量并带来更高的效率,因而被视为下一代DRAM发展的关键。

存储器市场中,3D NAND Flash早已实现商业化应用,3D DRAM技术则仍处于研发阶段。不过,随着AI、大数据等应用快速发展,高容量、高性能存储器需求也将攀升,未来3D DRAM有望成为存储器市场主流产品之一。
HBM技术开启了DRAM 3D化之路,让DRAM从传统2D走向了3D,不过当前的HBM并不能被认同为3D DRAM技术。三星4F Square VCT DRAM与3D DRAM概念更为接近,但这不是3D DRAM唯一的方向与目标,存储厂商对3D DRAM有着更丰富设想。
三星计划2030年实现3D DRAM商业化发展,2024年三星对外展示了两项3D DRAM技术,包括VCT和堆叠DRAM(Stacked DRAM),三星首先引入VCT技术,之后升级到堆叠DRAM,将多组VCT堆在一起,以持续提升DRAM容量与性能。针对堆叠DRAM,三星表示,其可充分利用Z轴向空间,较小面积容纳更多存储单元,单芯片容纳提升至100Gb以上。今年5月,三星表示,包括三星在内的一些公司已经成功制造出16层3D DRAM,他同时强调,现阶段公司不准备大规模生产3D DRAM产品。3D DRAM预计将通过晶圆对晶圆(wafer-to-wafer)等混合键合技术来制造,同时三星也在考虑把BSPDN(背面供电网络)技术应用于3D DRAM。
美光方面,据业界爆料,美光提交了与三星不同的3D DRAM专利申请,计划在不放置cell的情况下改变晶体管和电容器的形状。
SK海力士方面,6月韩媒BusinessKorea报道,SK海力士5层堆叠的3D DRAM的制造良率已达56.1%。这意味着在单个测试晶圆上制造的约1000个3D DRAM中,约有561个可行器件被生产出来。实验性的3D DRAM显示出与目前使用的2D DRAM相似的特性,业界表示,这是SK海力士首次披露其3D DRAM开发的具体数字和特性。
除此之外,美国NEO半导体公司(NEO Semiconductor)也在布局3D DRAM。去年,NEO半导体宣布推出全球首款3D DRAM原型:3D X-DRAM。该技术与3D NAND Flash类似,都是堆叠层数提高内存容量,有良率高、成本低、密度大幅提升等优点。
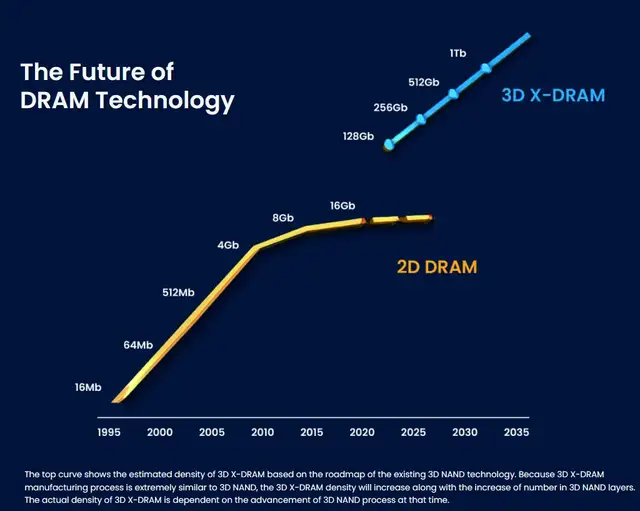
NEO半导体表示2025年将推出第一代3D X-DRAM就有230层堆栈,核心容量128Gb,相较2D DRAM内存16Gb容量,提升数倍。
本文作者可以追加内容哦 !

