
·聚焦:人工智能、芯片等行业
欢迎各位客官关注、转发
前言: 近期,随着人工智能大模型和汽车行业的高速发展,算力需求急剧上升。
在此背景下,每提升一点算力,都需要相应增加电源设施的配备,这使得电源模块在数据中心和车载领域成为了不可或缺的核心组件。
这一趋势促使了模拟厂商们纷纷加大投入,竞相研发创新技术,以满足市场需求。其中,一些全新的封装技术应运而生,展现了行业技术进步的显著成果。
作者 | 方文三 图片来源 | 网 络

封装技术对成本的影响与市场趋势
根据Yole Intelligence的报告,用于电源模块封装的材料成本在模块总成本中占比约为30%。
这表明封装材料的选择对电源模块的成本有着显著影响。
随着封装技术的不断创新,虽然提高了性能和可靠性,但同时也可能带来更高的研发和生产成本。
电源模块市场的增长,特别是AI大模型和汽车领域的需求激增,推动了封装技术的进步,同时也可能导致封装材料和制造成本的上升。
追求更高的功率密度和效率通常需要更复杂的封装技术,这可能会增加成本。
然而,长期来看,高性能封装技术可以提高产品的竞争力,从而可能带来更高的市场回报。
在选择封装技术时,工程师需要综合考虑性能、可靠性和成本效益。
虽然某些高性能封装技术初期投资可能较高,但通过优化设计和提高生产效率,可以在长期内实现成本效益。
随着技术的不断进步和市场需求的增长,封装技术的发展趋势将直接影响电源模块的成本结构。
电源模块封装技术对于电源模块的性能、可靠性和成本有着决定性的影响。
封装技术的进步不仅可以提高电源模块的功率密度和效率,还能有效减少电磁干扰(EMI),提升产品的整体性能。
电源模块封装技术正成为推动电源行业创新的重要力量,其市场增长和技术创新预示着电源模块封装技术将迎来更加广阔的发展前景。
据Yole发布的权威数据,电源模块市场展现出强劲的增长势头,预计从2023年的80亿美元基数上,将实现显著扩张,至2029年达到160亿美元,其间年复合增长率高达12.1%。
值得注意的是,电源模块的封装成本结构深受封装材料(涵盖芯片贴装及陶瓷衬底等关键材料)及封装尺寸的影响。
展望未来,该市场将延续其稳健增长轨迹,预计2023年至2029年间将以11%的年复合增长率持续攀升,最终于2029年达到43亿美元的市场规模。
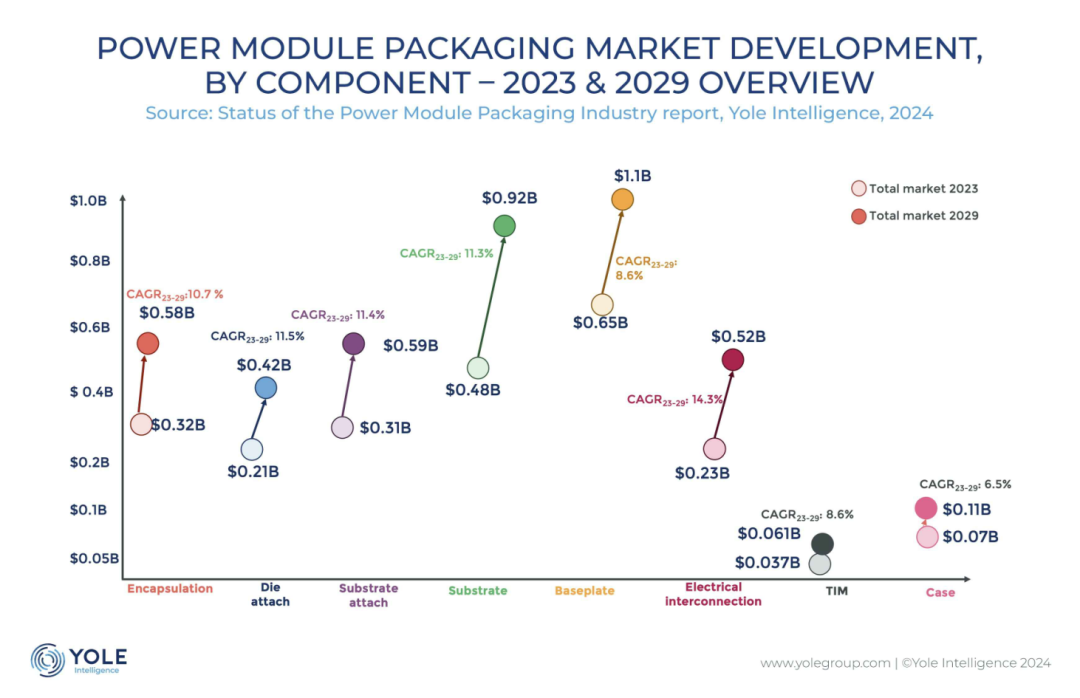
德州仪器推出MagPack封装技术
德州仪器(TI)近期推出的MagPack™磁性封装技术,作为其在电源模块技术领域的重大创新,展现出了高度的代表性。
据德州仪器升压—升降压开关稳压器产品线经理姚韵若所述,MagPack™技术的引入使得TI的电源模块在体积缩减的同时,能够输出更大的功率,从而实现了系统功率密度的显著提升。
具体而言,MagPack™封装技术具备四大显著优势:
其小型化设计与高功率密度的结合,为电源模块带来了前所未有的性能提升;
高效率与优异的散热性能确保了模块的稳定运行;
易于使用的特性有助于缩短产品上市周期,提升市场竞争力;
该技术还显著降低了电磁干扰,为系统的稳定运行提供了有力保障。
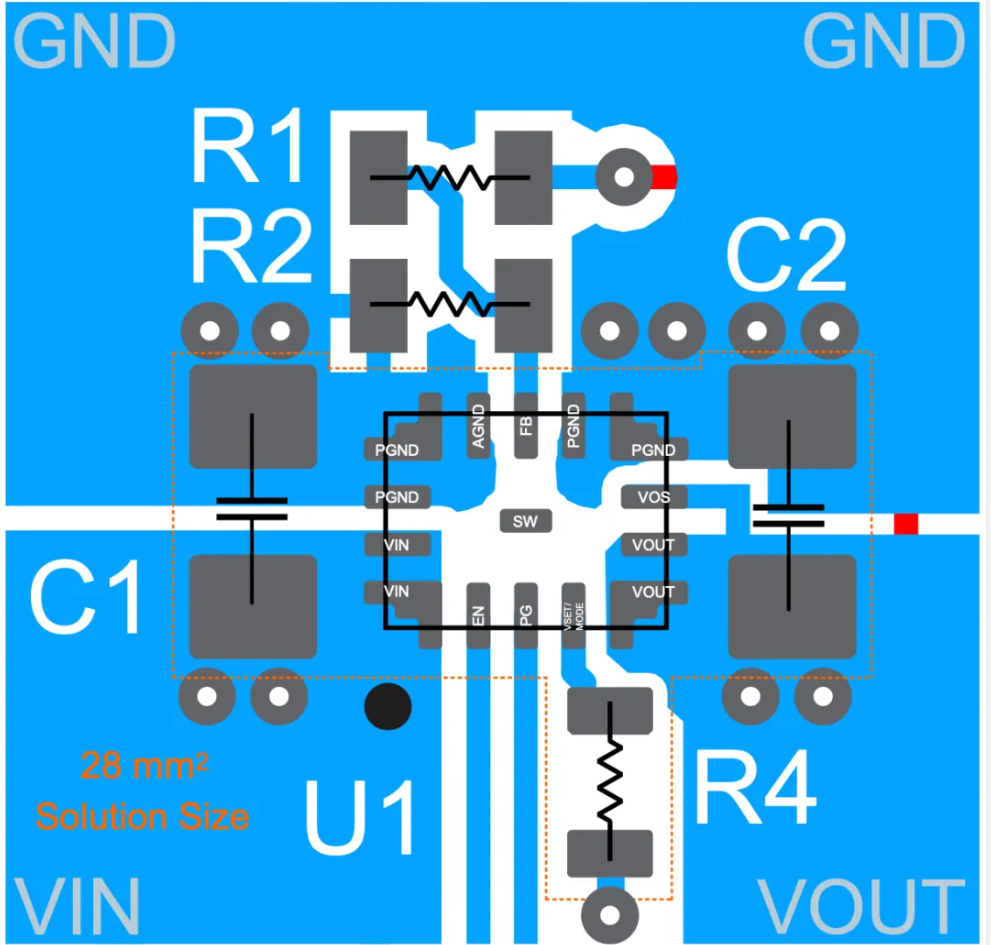
在实际应用中,基于MagPack™封装技术的德州仪器TPSM82866A、TPSM82866C和TPSM82816等电源模块,其体积相较于市场上同类6A电源模块缩小了23%;
相较于TI前代产品更是缩小了50%,展现了卓越的小型化能力。
在2.3mm×3mm的紧凑尺寸下,这些模块能够实现每平方毫米1A的电流输出,功率密度极高。
MagPack™封装技术通过集成电感器并优化电感器与电源IC的匹配,有效减少了直流和交流损耗,同时实现了低温升和优异的散热性能。
该技术采用全屏蔽封装设计,不仅屏蔽了电感器,还对电感器、电源IC和开关节点进行了全面屏蔽。
此外,通过优化封装内的系统布线,该技术进一步降低了系统内的噪声水平。
与前代产品相比,采用MagPack™封装技术的电源模块可将电磁干扰(EMI)辐射降低8dB。
基于MagPack™封装技术的优势,德州仪器于7月推出了六款新型电源模块。
其中TPSM82866A、TPSM82866C和TPSM82816作为超小型6A电源模块的代表,将为市场带来更加高效、可靠的电源解决方案。
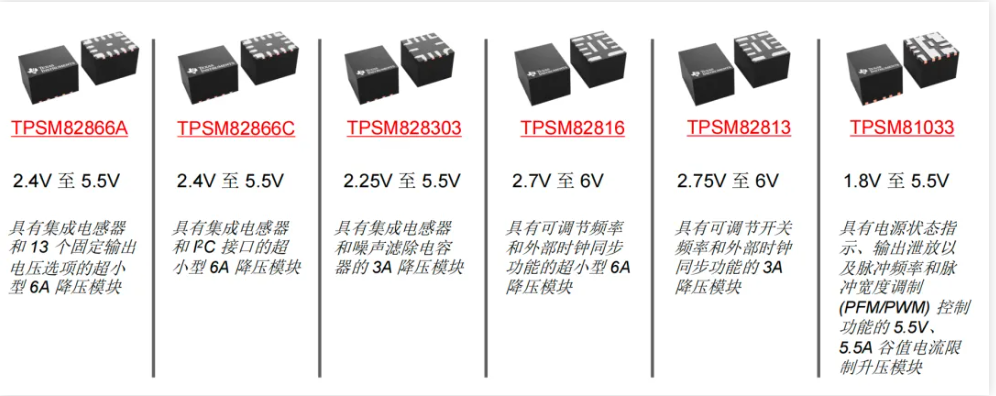
英飞凌推出Easy模块系列封装
为积极响应全球零碳化目标的迫切需求及市场对Easy模块需求的快速增长,英飞凌创新性地推出了全球化生产基地拓展战略“Easy Modules for the world”。
通过在全球各地构建贴近当地市场需求的后道工厂产线,实现了本地化生产,有效提升了交付的安全性与稳定性。
这一战略的实施,不仅增强了英飞凌在全球市场的竞争力,更为向各类应用提供更加优质、丰富的Easy碳化硅模块奠定了坚实基础。
碳化硅Easy模块,依据客户差异化的拓扑结构与芯片组合需求,实现了定制化设计,以全面满足各类应用场景。
该系列产品的Rds(on)值精准定位于55毫欧至2毫欧之间,并提供了多样化的拓扑结构选项,从而确保了产品的广泛适用性与市场需求的持续响应。
总结而言,Easy碳化硅模块在性价比、热管理、封装设计以及应用广泛性等方面均展现出显著优势。
无铜底板设计为用户提供了更具成本效益的解决方案;
氮化铝基板的应用有效降低了热阻并减少了散热成本;
灵活出PIN封装则优化了驱动回路与功率回路的布局;
PressFit Pin功能则进一步简化了系统的安装流程。
适用于光伏、电动汽车充电桩、ESS等多个工业领域的标准化与定制化解决方案中。

英飞凌率先在规格书中明确了碳化硅的短路能力标准,为客户提供了两种选择:
一是通过选用18V Vgs以降低Rds(on)值;二是采用15V Vgs以获得更强的短路承受能力。
英飞凌Easy模块以其卓越的可扩展性与灵活性著称。
自Easy 1B和2B模块上市以来,已广泛应用于多个领域。为了满足市场对更高功率系统的需求,进一步研发了Easy 3B和4B模块。
这两款封装产品不仅具备更高的功率密度与更大的电流承载能力,还采用了1200V CoolSiC™ MOSFET芯片技术,以更好地满足新兴应用对于高效、可靠性能的追求。
目前,1200V CoolSiC™ MOSFET M1H Easy模块已拥有丰富的拓扑结构选项,包括半桥、全桥、三相桥、三电平以及boost等,充分满足了不同应用场景的需求。
其中,半桥Easy3B模块的Rds(on)值更是低至2m,展现了其卓越的性能优势。
值得一提的是,DF4-19MR20W3M1HF_B11作为首个采用EasyPACK™ 3B封装的2000V CoolSiC™ MOSFET功率模块产品,专为1500V光伏系统而设计。
其出色的性能表现不仅简化了系统解决方案的复杂度并减少了器件数量,还显著提升了功率密度并降低了1500VDC应用的总系统成本。
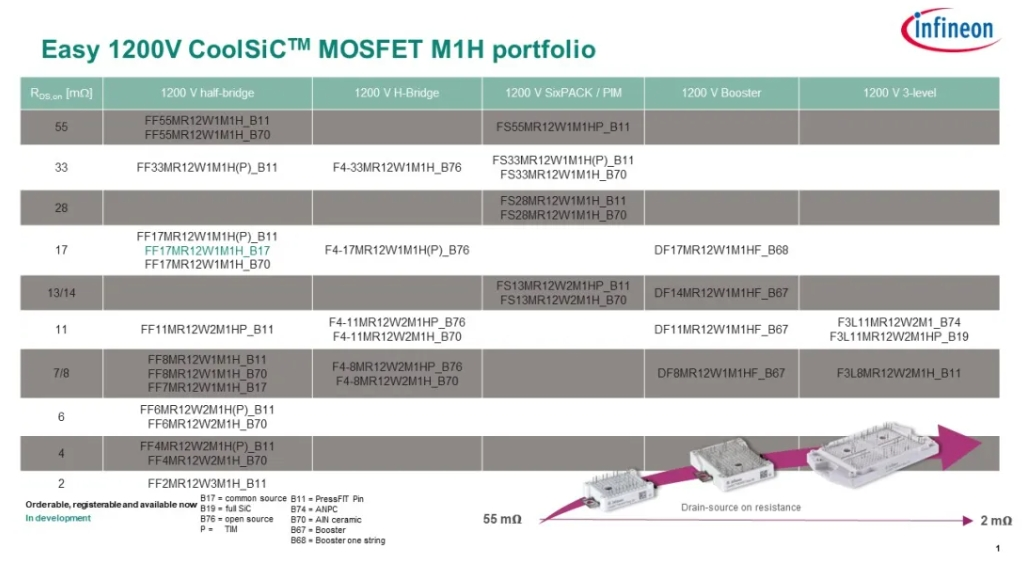
意法半导体推出ACEPack封装技术
ACEPack封装技术,作为ST(意法半导体)的标志性成果,历经长期验证,展现出其稳健可靠的特性,涵盖了硅IGBT及SiC MOSFET电源模块。
尤其值得一提的是,去年推出的ACEPack SMIT封装功率半导体器件,专为多种常用桥式拓扑设计,进一步巩固了ST在封装技术领域的领先地位。
相较于传统的TO型封装,ST的ACEPack SMIT封装技术实现了组装流程的简化与模块功率密度的显著提升。
其独特的贴装封装设计,结合顶部绝缘散热与直接键合铜(DBC)贴片技术,确保了高效的封装顶部冷却性能。
近期,ST更是推出了ACEPack DMT-32系列碳化硅(SiC)电源模块,该系列采用便捷的32引脚、双列直插、模制通孔封装,专为电动汽车(BEV/HEV)及工业应用领域精心打造。
凭借ST最先进的SiC技术与丰富的产品线,ACEPack DMT-32系列覆盖了车载充电器(OBC)、DC/DC转换器、流体泵、空调等众多电源与应用领域。
该系列功率模块采用SiC功率MOSFET技术,展现了卓越的电气与热性能,确保了低RDS(on)值与有限的开关能量。
同时,基于氮化铝的直接键合铜(DBC)封装设计,赋予了模块更高的导热性能、极低的热阻以及高电绝缘性。
其工作结温可高达175C,能够轻松应对高功率需求。
此外,特殊设计的模制凹槽确保了较大的爬电距离,进一步提升了模块的安全性能。
ACEPack DMT-32系列被设计为一站式解决方案,能够构建包括六组、四组及图腾柱配置在内的复杂拓扑结构,从而满足高功率密度与高效率的严苛要求,有效缩短了产品上市时间。
目前,该系列已提供1200V额定电压的产品,650V级别的产品亦即将问世,并均配备了嵌入式NTC热敏电阻以实现热保护。
其高性能氮化铝(AlN)绝缘基板确保了出色的热性能,而集成的NTC传感器则提供了实时的温度监控功能。
在量产方面,M1F45M12W2-1LA自2023年第4季度起已开始批量生产。
同时,后续型号如M1F80M12W2-1LA、M1TP80M12W2-2LA、M1P45M12W2-1LA、M1P80M12W2-1LA及M1P30M12W3-1LA等均已提供样品,并将于2024年第一季度正式进入批量生产阶段。

MPS推出Mesh Connect倒装封装
截至目前,MPS已壮大为一家半导体领域的领军企业,旗下拥有14条产品线,涵盖超过4000种产品。
MPS郑重声明,其产品在技术层面展现出显著的半导体工艺制程优势与封装技术特长。
MPS专注于模拟与数字模拟混合信号产品的研发与生产,此类产品所采用的制程技术非同凡响。
它摒弃了纯数字制程常用的CMOS工艺,转而采用由公司创始人Michael Hsing独创的BCD工艺。
在封装领域,MPS同样引领潮流。面对传统打线封装技术存在的导通电阻、寄生电感等问题,MPS创新性地引入了“Mesh Connect™”倒装封装技术。

该技术摒弃了接合线的使用,转而利用铜凸点和焊料直接将芯片与金属引线紧密结合,实现了热量从芯片至PCB的高效传导。
通过优化引线布局,确保电源、接地及输出引脚均有效连接至大面积铜区域,进而实现了热性能的显著提升。
根据MPS官方网站的介绍,相较于分立方案,MPS的模块在电路板空间占用上展现出惊人的优势,最高可节省70%的空间。
此外,晶圆球焊接技术的应用不仅降低了成本,还彻底消除了导通电阻的存在,有效规避了寄生电感对开关速度的不利影响。

Vicor面向AI推出ChiP封装
电源模块封装技术,作为Vicor的核心竞争力,自公司创立之初便成为其独特差异化标志。
1984年,Vicor推出了以封装命名的模块化砖型DC-DC转换器组件,该组件融合了分布式电源架构与高效准谐振正激转换器拓扑两大创新特性。
时至2015年,随着控制系统、拓扑结构、组件及材料的全面升级,VI Chip封装迎来了重新设计。
此次设计充分利用了功耗的显著降低、控制系统与拓扑结构的高频化优势,从而实现了功率密度与电流密度的双重提升。
这一创新成果被命名为转换器级封装(ChiP™),其独特的构造与制造方法为Vicor及整个电源模块制造行业开辟了全新的发展路径。
ChiP封装以其双面组件装配及从固定尺寸面板切割的独特方式而著称,这一过程与晶圆片制造中切割硅芯片的工艺颇为相似。

新架构结合高频开关拓扑及控制系统中的ZVS与ZCS优化,不仅进一步降低了功耗,还实现了电源模块集成度的显著提升,这正是推动VI Chip封装不断革新的核心动力。
ChiP封装在AI等高增长应用领域展现出了巨大潜力。
特别是在处理器电流强度已突破1000A的应用场景中,PCB铜箔电源层的配电损耗已成为制约性能的关键因素。
Vicor通过采用ChiP多层堆栈技术构建垂直供电结构,有效缩小了电路板尺寸并降低了基板功耗,进而提升了处理器的整体性能。
ChiP封装方法的核心理念在于最大限度地精简构成模块的各个组件与元件。
随着Vicor在性能提升方面的不断探索与突破,ChiP封装技术将继续刷新行业创新记录。

电源模块封装技术的发展趋势
随着电子器件技术的不断进步,电源模块的性能得到了显著提升,能够实现更高的效率、更低的能耗和更长的使用寿命。
同时,随着智能化技术的广泛应用,电源模块正逐渐实现智能化控制和管理,提高了设备的稳定性和可靠性。
随着全球环保意识的不断提高,电源模块产品将更加注重环保和可持续发展。
采用环保材料和生产工艺,降耗和减少废弃物排放,将成为电源模块封装行业的重要发展方向。
随着全球产业分工的不断深化和产业链的不断完善,电源模块封装企业将与上下游企业实现更加紧密的合作和协同。
通过产业链的优化和整合,实现资源共享、优势互补和降低成本,提高整个产业链的竞争力和创新能力。

结尾:
电源模块封装技术的发展不仅提高了电源模块的性能和可靠性,也为电源模块在数据中心、新能源汽车等关键领域的应用提供了强有力的支持。
电源模块封装技术,作为电源模块设计和制造的关键环节,正迎来前所未有的发展机遇。
随着技术的不断进步和市场需求的增长,电源模块封装技术正成为推动电源行业创新的重要力量。
电源模块封装技术对成本的影响主要体现在封装材料的选择和封装尺寸的设计上,这些因素共同决定了电源模块的总成本。
部分资料参考:电子工程世界:《电源模块封装技术,太热了》,德州仪器:《德州仪器推出电源模块全新磁性封装技术》,Vicor:《创新电源模块封装》,电子发烧友网:《让电源模块尺寸降50%,解读TI磁性封装技术MagPack™四大优势》,英飞凌工业半导体:《一文讲透英飞凌碳化硅Easy模块》
本公众号所刊发稿件及图片来源于网络,仅用于交流使用,如有侵权请联系回复,我们收到信息后会在24小时内处理。
END
本文作者可以追加内容哦 !

