近日,据集微网消息,日本已经设立目标,计划在未来在本国量产2nm制程的芯片。据电子时报报道,日本不仅在努力提高单个芯片晶体管密度,还计划为2nm芯片使用异构技术,将多个芯片组合在一起。

日本半导体公司Rapidus自2022年8月成立以来,一直专注于异构集成技术,试图通过2.5D、3D封装将多个不同的芯片组合在一起。根据Rapidus官网介绍,该公司计划与西方公司合作,开发下一代3D LSI(大规模集成电路),并利用领先的技术量产2nm及以下制程芯片。
日本经济产业省于2023年6月修订了《半导体和数字产业战略》,将2.5D、3D封装以及硅桥技术,确定为2020年代末之前需要取得突破的技术。经济产业省的目标是启动先进半导体技术中心(LSTC),与Rapidus以及海外研究机构和制造商合作,共同开发这些技术,并将先进封装技术应用于2nm及以下芯片。这将对芯片先进封装有着里程碑意义!
从历史沿革看,微电子技术大致遵循着“摩尔定律”快速发展。但近年来,随着芯片制程工艺的演进,“摩尔定律”迭代进度放缓,导致芯片的性能增长边际成本急剧上升。据IBS统计,在达到 28nm制程节点以后,如果继续缩小制程节点,每百万门晶体管的制造成本不降反升。

此次日本计划基于 IBM 2nm 工艺技术开发“Rapidus 版”制造技术,2025 年开始逻辑半导体试产,2027 年量产。那对先进封装的要求和增量将史无前例的高。
另据财联社消息,7月20日电,台积电表示,先进封装能力将大约增加一倍。

的确,随着人工智能和数字经济的告诉发展,高性能计算的应用场景不断拓宽,人工智能芯片已经供不应求。

对算力芯片性能提出更高要求,进而拉动了先进封装及Chiplet工艺的需求。随着AI大模型数据处理需求的持续提升,对算力芯片性能提出更高要求。Chiplet是高性能算力芯片的封装解决方案之一,其在设计、生产环节均进行了效率优化,能有效降低成本并持续提高系统集成度。Chiplet需要采用先进封装工艺中的异构集成技术进行实现,因而Chiplet的高增长亦将带动异构集成的需求提升。根据Omdia预测,随着人工智能、高性能计算、5G等新兴应用领域需求渗透,2035年全球Chiplet市场规模有望达到570亿美元,2018-2035年复合年均增长率为30.16%,发展势头强劲。
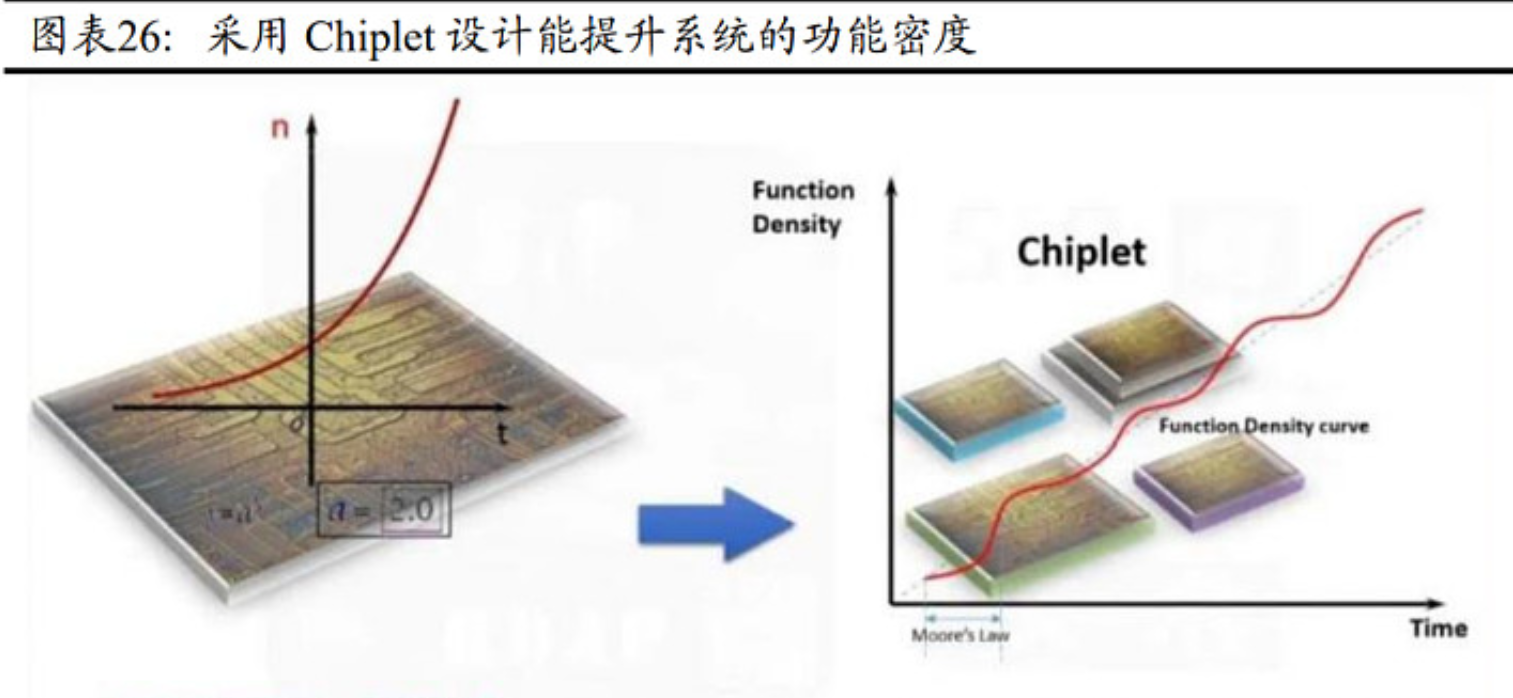
与传统SoC相比,Chiplet在设计灵活度、良率等方面优势明显。相对单片集成技术SoC而言,Chiplet是由不同工艺节点的模块共同组成,在相同的系统性能目标下,部分模块对制程的要求有所降低,节省了部分开发时间;由于芯片面积越大越容易产生缺陷,而Chiplet每个模块的载体都是较小的硅片,有效降低了生产中产生的缺陷数量;同时每个小硅片拥有单独的IP,并且可以重复使用,根据特定客户的独特需求定制产品,节省开发时间。不同工艺生产制造的Chiplet可以通过SiP技术结合,典型的方案就是XPU+DRAM,通过异构集成把内存和算力单元直接整合到一起,提升系统性能、突破算力瓶颈。
把握大算力时代浪潮下先进封装产业的投资机会
1、先进封装是后摩尔时代下确定性的产业趋势:先进封装是半导体产业超越摩尔定律、提升系统性能的必然选择,为封测市场带来主要增量,且应用场景主要在高性能计算、高端服务器等领域,产品技术壁垒与价值量相对传统封装会更高,重点关注传统封装厂商技术升级带来的投资机会。
2、Chiplet有望成为高端算力芯片的主流封装方案,助力国产芯片“破局”:大算力时代下,高性能计算的应用场景不断拓宽,对算力芯片性能提出更高要求,进而拉动了先进封装及Chiplet工艺的需求;此外,Chiplet降低了芯片设计的成本与门槛,且其IP复用的特性提高了设计的灵活性,在国内发展先进制程外部条件受限的环境下,Chiplet有望成为国产芯片“破局”路径之一,重点关注Chiplet技术领先 、具备量产能力的龙头厂商。
3、国内先进封装产业蓬勃发展将拉动国产设备需求:在先进封装工艺中,对传统封装设备的使用需求和精度要求都有所提升,同时由于工艺延伸至前道环节,为前道设备带来增量,提升了半导体设备的市场需求,也进一步推进了半导体设备的国产替代进程,重点关注布局封装环节设备的优质厂商。
综上,建议重点关注大算力时代浪潮下具备先进封装技术领先 优势和客户资源优势的龙头厂商,以及受益国产替代及先进封装产业发展红利的上游设备厂商
甬硅电子688362
甬硅电子专注于中高端先进封装和测试业务,报告期内公司全部产品均为中高端先进封装形式,包括 FC 类产品、 SiP 类产品、BGA 类产品等,属于国家重点支持的领域之一。

公司在SiP领域具备丰富的技术积累,同时通过实施晶圆凸点产业化项目布局“扇入型封装”(F an-in)、“扇出型封装”(F an-out)、2.5D、3D等晶圆级和系统级封装应用领域,并为进一步拓展异构封装领域打下基础。
另一方面,FC类产品中除现有产品外,公司持续完善公司自身产品线布局,积极推进FCBG等产线的实施,努力打造成为最具竞争力的一站式Turnkey封测基地。

颀中科技688352
公司的主要从事集成电路的先进封装与测试业务,目前主要聚焦于显示驱动芯片封测领域和以电源管理芯片,射频前端芯片为代表的非显示类芯片封测领域。公司也是全国唯一一家能够提供DDIC全制程段封测服务的企业。
颀中科技能够为客户提供全方位一站式先进封测的解决方案,包含凸块加工、晶圆测试、研磨切割、封装测试等制程服务,以及光罩设计、COF卷带图面设计、测试程式开发、探针卡设计及维修等配套服务。公司为显示驱动芯片提供COF/COG/COP封装方案,具备行业领先的全方位的显示封装技术,可以为客户提供12um超细间距Super Fine Pitch COF、双面铜2-Metal COF、多芯片Multi-Chip COF、125mm大版面COF及多种散热解决方案。

联瑞新材688300
公司持续聚焦面向先进封装材料以及面向5G高频高速覆铜板应用需求的球形陶瓷粉体材料的研发。先进芯片封装用电子级亚微米球形硅微粉、底部填充胶用化学合成球形二氧化硅微粉、高可靠车载板用低杂质硅微粉等项目已经结题并实现产业化。
2021年8月15日,联瑞新材发布公告称,为了持续满足新一代芯片封装、高频高速电路基板等领域的客户需求,不断完善球形硅基和铝基产品的产能布局,进一步扩大球形粉体材料产能,拟投资3亿元实施年产15000吨高端芯片封装用球形粉体生产线建设项目。目前该项目已于2022年四季度顺利调试,2023年上半年已向市场投放一半产能,公司对下半年需求预期持乐观态度。

德邦科技688035
公司集成电路封装材料部分产品可应用于2.5D和3D等先进封装互连技术。其中DAF、CDAF相关产品可应用在集成电路芯片的多维封装、叠加封装等高端封装工艺中,竞争对手以国际封装材料企业为主,国内未看到其他友商能够生产。

此前财通证券发布研报,给予德邦科技增持评级。评级理由主要包括:先进封装技术带动公司相关集成电路封装材料需求高增; AI技术的应用将带动智能终端需求的提升,受益公司相关智能终端材料
同兴达002845
2022年,深圳同兴达与千灯镇及日月新集团达成合作,建设同兴达半导体先进封装项目。该项目预计总投资30亿元,一期总投资9.8亿元,达产后产值预计32亿元纳税1.7亿元。双方将共建"芯片先进封测(Gold Bump)全流程封装测试"生产线,由昆山同兴达投资 Gold Bumping(金凸块)段所需设备、晶圆测试段测试机、COF/COG 段所需专用设备至生产线所在地,产能配置 2万片/月。

2023年2月1日,同兴达半导体先进封装项目首台”SMEE光刻机”正式搬入昆山厂房。

本文作者可以追加内容哦 !

