1200-2000V的SiC 器件已经逐渐广泛被采用,但是要跟3.3 kV 以上的双极型硅基IGBT技术竞争,单极型SiC器件(MOSFET 和肖特基二极管)的导通电阻(Ron,sp)必须进一步降低,而SiC 超结 (SJ) 技术是实现这一目标的关键之一。
业界已经使用多外延工艺和侧壁注入实现了800-1700 V SiC SJ 器件。然而,业界暂无可行的大规模生产技术,这是由于 4H-SiC 中的低扩散系数,通常需要超过五次外延重复操作,意味着不能使用硅基SJ制造中常见的退火工艺。
制造SiC SJ 的另一种方法是通过沟槽外延,即在 n-(或 p-)4H-SiC 外延层中蚀刻出沟槽,然后通过部分选择性外延工艺,用 p-(或 n-)4H-SiC 重新填充。这种方法已在 4H SiC 中通过 1650℃的外延生长得到证实;然而,这种方法也存在一些局限性。
例如:在 4H-SiC 外延层干法蚀刻过程中形成微沟槽;外延前无意中发生的高温 H2 退火导致 4H-SiC 沟槽侧壁变圆;在重新填充的沟槽内形成空隙;小面生长问题等。
近日,华威大学工程学院的一项突破性的研究提供了一种新的沟槽外延方法,该研究团队在1550C的较低生长温度下,使用过饱和氯化化学方法重新填充4H-SiC的外延沟槽。这种方法带来了2大好处:
更好地保持了沟槽的完整性;
减少了因高温H2退火导致的沟槽侧壁变圆的问题。
获取该文献,请加许若冰hangjiashuo999,详情请往下看:
准备步骤
首先,研究团队在直径为100毫米的高掺杂(n+)4H-SiC衬底上,使用低压化学气相沉积(LPCVD)技术在4H-SiC衬底上形成SiO2保护层,以保护4H-SiC不受沟槽制造过程中的污染。
第二步,利用光刻、镍溅射和剥离等技术对硬掩模进行图案化,确定等效宽度为2m和4m的网格和沟槽;再使用ICP蚀刻技术,以SF6和氩气蚀刻沟槽至5m深。
经过清洗等准备工作后,开始进入外延生长环节——在LPE ACiS M8 RP-CVD反应器中进行图案晶片的外延生长,使用H2载气进行生长,生长温度设定为1550C。
引入HCl及结论展示
最重要的一步,该研究团队在工艺中引入额外的盐酸,流速分别为0、500和2000 sccm,结果如下图所示:
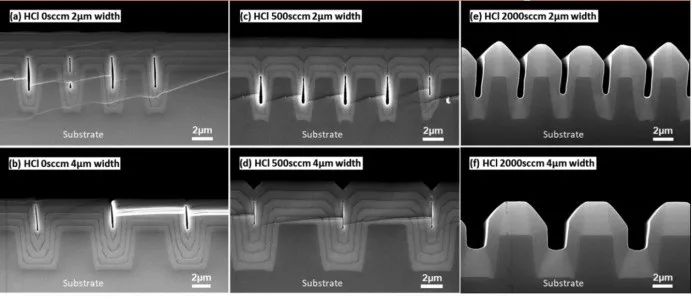
图1:2lm和4Im宽4H+Si℃ 沟槽填充物的扫描电镜显微照片,(a) 和 (b)无 HCl ;(c) 和 (d)是500 sccm HCl;(e) 和 (f)是2000 sccm HCl。
通过对沟槽填充观察,该研究团队可以得出以下结论:
在不含HCl的生长过程中,沟槽内和上方会过度生长中形成空洞;
加入500 sccm的盐酸后,填充过程更加均匀,4H-SiC明显偏向于在衬底的确定晶面上生长,4H-SiC的表面形态有所改善;
在2000 sccm HCl样品中,2m和4m沟槽的重新填充不完全,表明随着HCl流量的增加,沟槽中4H-SiC的生长率降低。
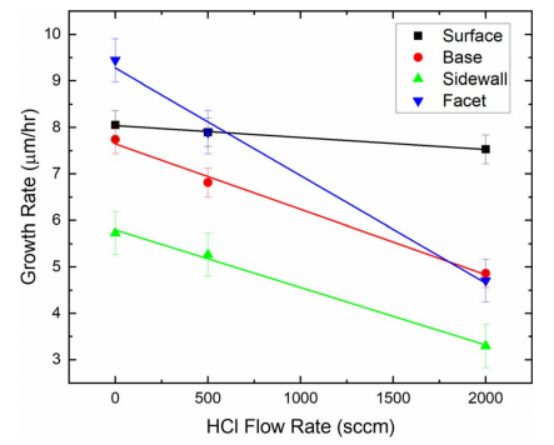
从图1图像中提取的 4H-SiC 在表面和沟槽侧壁上的生长速度
结论表明,通过精确控制盐酸的流量,可以显著影响4H-SiC在沟槽内的生长。适量的盐酸不仅能够促进沟槽内材料的均匀生长,还能改善表面的形态,为制造超结器件提供了关键的一步。
此外,该研究还评估了沟槽方向对生长方向的影响——发现在-1.5 < hmis < +1.5的范围内,生长角hgrowth保持在接近0的水平,这为制造这种沟槽结构提供了宽广的工艺窗口和容差。

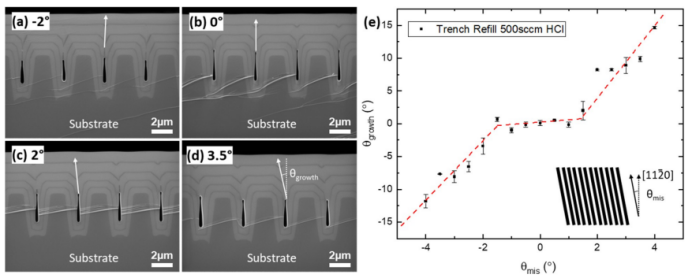
该团队认为,4H-SiC 同质外延沟槽再填充为 SJ 器件结构提供了一种可扩展的途径,无需依赖离子注入。
他们已经使用氯化化学方法在1550℃下实现了5 微米、宽度为2/4 微米的沟槽填充,同时通过将生长温度降低抑制了意外的 H2 退火以及随后的沟槽结构圆化。而且该方法观察到有效的再填充,4H-SiC 外延层保持单晶性,不会产生额外的缺陷。
该研究表明,选择正确的 HCl 流速,以从 4H-SiC 晶体生长改善和熔融外延层表面形貌减小中获益,同时保持沟槽中足够的生长速率,这对于 SJ 结构的形成至关重要。了解 4H-SiC 沟槽通过外延填充的机制对于开发可重复的 SJ 器件结构制造工艺至关重要,这可以克服当前基于 4H-SiC 的功率器件的限制。

·END·
转发,点赞,在看,安排一下

近15亿!该企业扩建8吋SiC/GaN产线
年产20万台,一汽将建SiC项目
新增4起SiC合作,剑指主驱、光储应用
本文作者可以追加内容哦 !

