当前,在人工智能AI、高性能计算HPC、数据中心以及自动驾驶汽车等新兴应用的推动下,FOPLP方法凭借显著提高计算能力,减少延迟并增加带宽的优势成功引起了业界对FOPLP技术的注意,越来越多的厂商也开始加入到这一竞争赛道。
近日,半导体设备厂商盛美上海推出了用于FOPLP的Ultra ECP ap-p面板级电镀设备。而在此前,盛美上海还推出了适用于扇出型面板级封装应用的Ultra C vac-p负压清洗设备。这意味着盛美上海已经成功进军高增长的扇出型面板级封装FOPLP市场。
值得一提的是,自今年二季度以来,AMD等芯片厂商积极接洽台积电及专业封测代工厂(OSAT)以FOPLP技术进行芯片封装,扇出型面板级封装也因此愈发受到业界的关注。
事实上,先进封装对于满足低延迟、高带宽和高性价比半导体芯片的需求变得越来越重要。而扇出型面板级封装能够提供高带宽和高密度的芯片互连,因此具有更大的发展潜力。
FOPLP是在更大的方形载板上进行扇出制程,可以将多个芯片、无源器件和互连集成在面板上的单个封装内,能提供更高的灵活性、可扩展性以及成本效益。
由于可在更大的矩形面板上重新分配芯片,扇出型面板级封装为封装大型图形处理器(GPU)和高密度高带宽内存(HBM)节约了大量成本。
据悉,传统硅晶圆的使用率低于85%,而面板的使用率高于95%。600x600毫米面板的有效面积是300毫米传统硅晶圆有效面积的5.7倍,面板总体成本预计可降低66%。面积利用率的提高带来了更高的产能、更大的AI芯片设计灵活性以及显著的成本降低。
目前,FOPLP先进封装领域的玩家主要包括力成、日月光、矽品、台积电、群创、纳沛斯半导体及三星电机等。
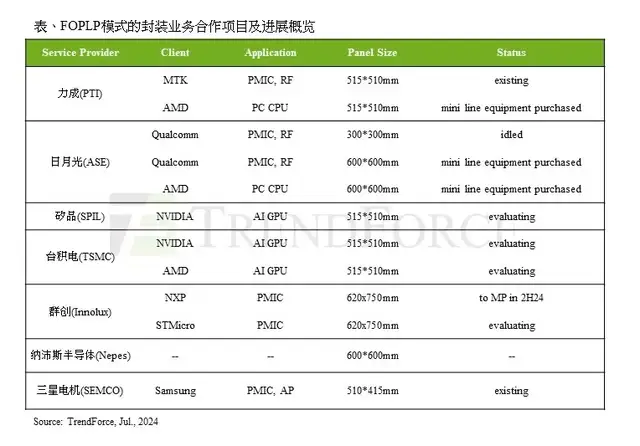
TrendForce集邦咨询认为,FOPLP技术的优势及劣势、发展机会及挑战并存。主要优势为低单位成本及大封装尺寸,只是技术及设备体系尚待发展,技术商业化的进程存在高度不确定性,预估目前FOPLP封装技术发展在消费性IC及AI GPU应用的量产时间点,可能分别落于2024年下半年至2026年,以及2027-2028年。
本文作者可以追加内容哦 !

